Optimization of the Solder Ball Array to Minimize Chip Warpage
Application ID: 124581
The ball grid array (BGA) technology is a surface-mount technology widely used in electronic packaging. Usually, there are two types of solder balls considered in the array, including the functional balls that are required for electric connections and the support balls that are used only for reinforcement. In this model, the placement of the support solder balls in the array are optimized to minimize the warpage of the chip during operation.
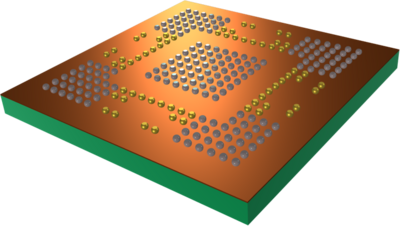
This model example illustrates applications of this type that would nominally be built using the following products:
however, additional products may be required to completely define and model it. Furthermore, this example may also be defined and modeled using components from the following product combinations:
The combination of COMSOL® products required to model your application depends on several factors and may include boundary conditions, material properties, physics interfaces, and part libraries. Particular functionality may be common to several products. To determine the right combination of products for your modeling needs, review the Specification Chart and make use of a free evaluation license. The COMSOL Sales and Support teams are available for answering any questions you may have regarding this.



